上一篇文章中我们以“什么是热设计”为标题,大致介绍了半导体元器件热设计的重要性。本文我们希望就半导体元器件的热设计再进行一些具体说明。
技术发展趋势的变化和热设计
近年来,“小型化”、“高功能化”、“设计灵活性”已经成为半导体元器件技术发展趋势。在此我们需要考虑的是半导体元器件的这些趋势将对热和热设计产生怎样的影响。
“小型化”
产品的小型化需求,推动了IC、安装电路板、其他电容器等元器件的小型化。在半导体元器件的小型化进程中,例如封装在以往TO-220之类的通孔插装型较大封装中的IC芯片,如今封装在小得多的表面贴装型封装中的情况并不少见。

而且,还采用了一些提高集成度的方法。例如将同一封装中搭载的IC芯片调整为2个将其双重化,或者通过放入相当于2个芯片的芯片来提高集成度,从而增加单位面积的功能(功能面积比)。
这样的元器件小型化和高度集成,将会使发热量增加。实例如下所示。左侧的热图像是封装小型化的示例,是功耗相同的20×20×20mm封装和10×10×10mm封装的比较示例。很明显,较小封装中表示高温的红色更为集中,即发热量更大。右侧为高集成度的示例,对相同尺寸封装中使用1枚芯片和2枚芯片的产品进行对比时,可以明显看到温度的差异也非常明显。
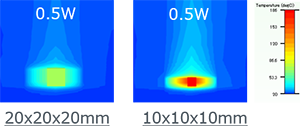

而且还进行了高密度安装,即将小型化、高度集成后的元器件高密度且双面安装在小型电路板上,然后将电路板装满壳体。

高密度安装减少了散热到电路板上的表面贴装型器件的有效散热范围,发热量增加。若壳体内的环境温度较高,可以散发的热量会减少。从结果来看,虽然原来只有发热元器件周围为高温,但现在整个电路板都呈高温状态。这甚至导致发热量较小的元器件温度升高。
要想提高设备的功能,需要增加元器件,或使用集成规模更大、能力更高IC,并且还需要提高数据的处理速度、提高信号的频率等。这些方法使功耗呈日益增加趋势,最终导致发热量增加。此外,在处理高频时,为了抑制噪声辐射,很多情况需要进行屏蔽处理。由于热量会蓄积在屏蔽层内,因此对于屏蔽层内的元器件而言,温度条件变得更差。而且很难以提高功能为理由而扩大设备尺寸,因此会变成上述的高密度状态,从而导致壳体内的温度升高。
“设计灵活性”
为了使产品与众不同或体现美感,越来越多的产品开始重视设计性,甚至优先考虑设计灵活性。其弊端在于,由于过度地高密度安装和无法合理散热而导致壳体出现高温的情况。简而言之,就是手拿着便携设备,会觉得很烫。为了提高元器件的设计灵活性,即外形的自由度,如上所述可采用小型或扁平的产品,但是更加优先考虑设计灵活性的产品不在少数。
问题不仅仅在于发热量增加和散热困难
如上所述,由于“小型化”、“高功能化”、“设计灵活性”这三种技术发展趋势的变化,已经导致发热量增加,相应地,散热也变得更难。因此热设计面临着更严苛的条件和要求。确实这是一个非常大的问题,但同时还有一个问题需要我们去考量。
多数情况下公司的设备设计中都设置了对热设计的评估标准。如果该评估标准比较老旧,未考虑到最近的技术发展趋势并重新进行修改,那么该评估标准本身就存在问题。若未进行此类考量,且根据未考虑到现状的评估标准进行设计,则可能会发生非常严重的问题。
为了应对技术发展趋势的变化,需要对热设计的评估标准进行重新修订。